フォトリソグラフィのいろは ~PEB編~

寒くなってきましたね。
ねねは寒いのが苦手です。
せき込む人をちらちらと見かけますので、
皆さんも体調にはお気を付けください…。
前回の記事 http://フォトリソグラフィのいろは ~ベイク編~
前回の記事では目的の異なる3つのベイク工程の内、下線の2つを紹介しましたね。
①プリベイク
②ポストエクスポージャーベイク
③ポストベイク
今回は残りの1つ、②ポストエクスポージャーベイクについてお話しします。
②ポストエクスポージャーベイク…露光後
これは頭文字から、通称”PEB”と呼ばれることが多いです。
PEBを使う場合のパターンは2つあります。
1. 化学増幅型レジストを使っている場合
レジストの種類の中に化学増幅型レジストというものがあります。
化学増幅型レジストは通常のレジストと反応機構が異なり、高感度であることが特徴です。
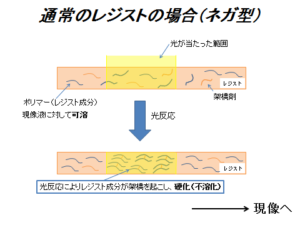
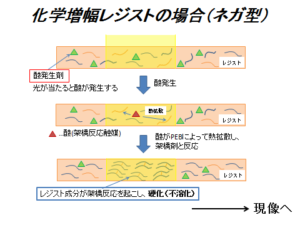
(通常のレジストの方は光反応開始剤の存在を省いてしまってます、すみません)
上図から、
通常のレジストは露光と同時に架橋が起こるのに対し、
化学増幅型レジストはPEBと同時に架橋が起こっています。
この酸触媒の熱拡散による反応のおかげで、化学増幅型レジストは少ない光でパターンが描けているのです。
ですので、化学増幅型レジストにはPEB工程が存在するわけです。
2.定常波の影響により、パターンに凹凸がある場合
光は波の性質を持つので、露光時の入射光と基板等からの反射光で
定常波を成し、波打った形状で露光されることがあります。
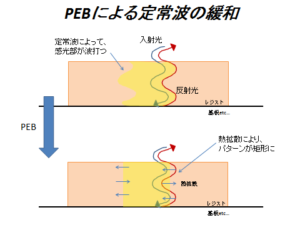
すると現像後にパターンの壁の部分が波打ったパターンになってしまいます。
そのような場合にPEB工程を行うことで、熱拡散によって定常波を緩和することができます。
以上、2回に渡ってベイクのことについて紹介してみました。
次回もお楽しみに…

