テクダイヤのコーポレートサイト(https://www.tecdia.com/jp/)に新コンテンツ「未知との遭遇」を追加しました。テクダイヤの9つの得意技と、過去実績を紹介するページです。技術ブログでは、それぞれの技術と実績を、より詳しくご紹介!第五弾は「チップ化技術」です。
半導体ウェハからチップを綺麗に切り出します!~テクダイヤ技術紹介「チップ化技術」~

半導体ウェハからチップを綺麗に切り出します!
「チップ化技術」とは、半導体ウェハからチップを切り出す技術です。半導体ウェハをダイシングまたはスクライビングという技術でチップカットします。テクダイヤは、サイズ0.2mmのチップ化、テープ上に貼りつけたままのカット、サファイアなどの硬い素材など、幅広い実績があります!

ダイシングとは
ダイシングとは、ウェハ上に形成された集積回路を切断し、チップ化する工程のこと。
実績1:ダイシング・オン・テープ
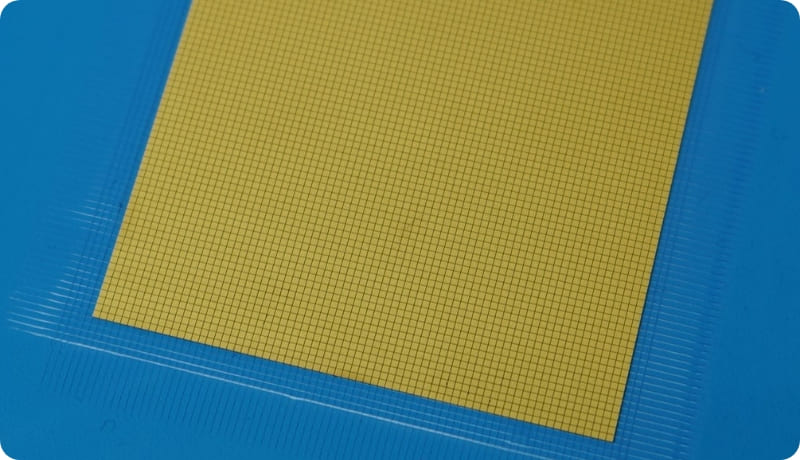
テクダイヤは、ウエハをテープ状に張り付けたままチップ化切断することができます!
実績1:ダイシング・オン・テープ
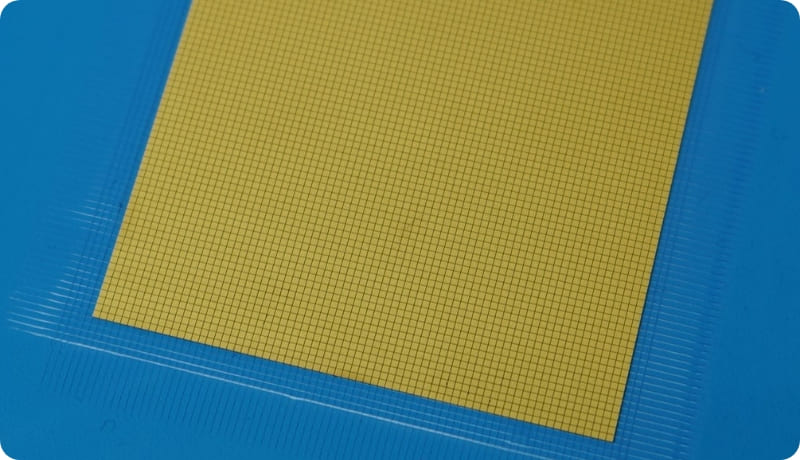
テクダイヤは、ウエハをテープ状に張り付けたままチップ化切断することができます!
スクライビングとは
スクライビングとは、ダイヤモンド工具やレーザーなどを用いて、材料の表面に微小な溝を形成すること。
実績2:ブルーLED

ダイヤモンド・スクライブ法でチップ化します。サファイアなど硬い素材に有利な方法です!
実績3:SiC(シリコンカーバイド)のチップ化

地球上で3番目に固い硬物であるSiC(シリコンカーバイド)。SiCウェハのチップ化は、ダイシングでは切削速度が遅く、レーザーではデブリが発生したり装置が高価という問題がありましたが、テクダイヤ開発のスクライブ技術で、精密なチップ化を実現!
詳しくはこちらから
実績4:InP(リン化インジウム)ウェハの高精度スクライブ
次世代通信インフラ(5G/6G通信、データセンター)向けの市場において、採用されている化合物半導体InP(リン化インジウム)。InP半導体の品質はそのままに低コスト化が求められている中、狭いストリート幅を有するInPウェハに適したダイヤモンドスクライバーを提案し、5Gフロントホール向けのチップ化工程に採用いただきました。
詳細はこちらから
実績5:メサ型ストリート基板チップ化のソリューション提供
カット工法を著しく制限する「メサ型ストリート」基板のチップ化に適したダイヤモンドスクライブツールをカスタマイズで製作し、顧客の課題を解決!
詳細はこちらから
実績6:ZnO(酸化亜鉛)ウェハのパーフェクトスクライブ
ZnO(酸化亜鉛)ウェハは、水や熱に弱い性質があるため、一般的に使用されるダイシング工程や、レーザーカット工程では、チップ化に困難がありました。そこで、テクダイヤのもつスクライブツールを社内独自の研磨技術を用いて、新たな刃先を開発。加えて、*スクライブ装置にある、多彩なカット工法を駆使して条件開発。結果、綺麗なカットを実現しました。
*スクライブ装置については株式会社くまさんメディクスにお問い合せください。
詳細はこちらから
実績2:ブルーLED

ダイヤモンド・スクライブ法でチップ化します。サファイアなど硬い素材に有利な方法です!
実績3:SiC(シリコンカーバイド)のチップ化

地球上で3番目に固い硬物であるSiC(シリコンカーバイド)。SiCウェハのチップ化は、ダイシングでは切削速度が遅く、レーザーではデブリが発生したり装置が高価という問題がありましたが、テクダイヤ開発のスクライブ技術で、精密なチップ化を実現!
詳しくはこちらから
実績4:InP(リン化インジウム)ウェハの高精度スクライブ
次世代通信インフラ(5G/6G通信、データセンター)向けの市場において、採用されている化合物半導体InP(リン化インジウム)。InP半導体の品質はそのままに低コスト化が求められている中、狭いストリート幅を有するInPウェハに適したダイヤモンドスクライバーを提案し、5Gフロントホール向けのチップ化工程に採用いただきました。
詳細はこちらから
実績5:メサ型ストリート基板チップ化のソリューション提供
カット工法を著しく制限する「メサ型ストリート」基板のチップ化に適したダイヤモンドスクライブツールをカスタマイズで製作し、顧客の課題を解決!
詳細はこちらから
実績6:ZnO(酸化亜鉛)ウェハのパーフェクトスクライブ
ZnO(酸化亜鉛)ウェハは、水や熱に弱い性質があるため、一般的に使用されるダイシング工程や、レーザーカット工程では、チップ化に困難がありました。そこで、テクダイヤのもつスクライブツールを社内独自の研磨技術を用いて、新たな刃先を開発。加えて、*スクライブ装置にある、多彩なカット工法を駆使して条件開発。結果、綺麗なカットを実現しました。
*スクライブ装置については株式会社くまさんメディクスにお問い合せください。
詳細はこちらから
気軽にお問い合わせください!
お客様のお悩み、新製品開発のアイデアなど、まず気軽にお問合せください。テクダイヤは、言われたとおりに製造するのではなく、創業から培った技術やノウハウ、そして強みである提案力を生かし、お客様の課題解決、アイデア実現に貢献します。
【関連サイト】
テクダイヤ株式会社コーポレートサイト
新コンテンツ「未知との遭遇」
ケーススタディ(事例紹介)
【関連サイト】
テクダイヤ株式会社コーポレートサイト
新コンテンツ「未知との遭遇」
ケーススタディ(事例紹介)

