今回は半導体製造工程の主要な工程の1つであるエッチング工程について紹介させていただきます。
エッチング工程は、ウェハ上に回路を描くフォトリソ工程が完了した後に、不要な層を選択的に除去する工程です。
エッチング工程は液体を使用するウェットエッチング工程とガスやプラズマを使用するドライエッチング工程とに分けられます。
半導体製造におけるエッチングとは

・ウェットエッチング
ウェットエッチングは硫酸や硝酸、リン酸、フッ酸などの薬液を使用した腐食作用によって形成した薄膜の形状加工を行っていきます。
低コストでエッチング速度が速く、生産性に優れている、ウェハに与えるダメージが少ないという利点があります。
しかしその一方で全方向に同一の速度でエッチングされる (等方性エッチング 図1参照) ため、レジストで作製したマスクと下地の被エッチング膜との界面にエッチング液がしみこみ横方向にもエッチングが進行してしまう(オーバーエッチング)という問題があります。
このため溶液がしみこんだ部分の加工寸法の精度が低くなるため、精度が求められる微細パターンの加工には向いていません。
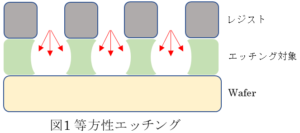
・ドライエッチング
ドライエッチングとは真空容器内にて放電プラズマを使用した処理プロセスです。 ウェットエッチングでの問題を解決する手段として開発されました。 薬液の選定が難しく、エッチングしづらいものも問題なくエッチングすることができます。
ドライエッチングは、エッチングの種類によって主に以下の2つに分けられます。
① スパッタエッチング ② 反応性イオンエッチング
スパッタエッチングとは真空中に導入した反応性のガスをプラズマにし加速したイオンをぶつけることで削って行く方法です。
まず真空中に反応性ガスを投入し高周波電源等による電圧を利用してグロー放電によるプラズマを発生させます。その後、プラズマ中の陽イオンを基板側に発生しているVDCによって引き付け、エッチングをしたい物資へ向かって加速させ真っ直ぐに衝突させることで削っていきます。
この方法は異方性(図2参照)であるため、横方向と縦方向のエッチング速度が異なり、微細な加工が可能となります。
その一方で、イオンの衝突から生じる物理的反応のみを利用するため、エッチング速度が遅くなります。
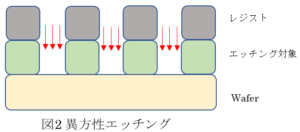
反応性イオンエッチングとは化学的作用と物理的作用を併せ持った方法です。
これは真空中に入れた反応性のガスをプラズマにして加速したイオンをぶつけることで削って行くと同時に、プラズマの励起で生成されるラジカルを利用する化学エッチングで酸化膜を除去します。この方法はスパッタエッチングよりエッチング速度が速く、さらに微細な加工が可能です。
ドライエッチングは微細な半導体回路の歩留まりを向上させるために近年では広く使用されています。
しかし、ウェットエッチングも一気に大量の枚数を処理でき、ダメージフリーでプロセス後もクリーンであるなどから今でも一部の工程で使われています。
目的に合わせて工程を選ぶことが重要です。
ドライエッチングは、エッチングの種類によって主に以下の2つに分けられます。
① スパッタエッチング ② 反応性イオンエッチング
スパッタエッチングとは真空中に導入した反応性のガスをプラズマにし加速したイオンをぶつけることで削って行く方法です。
まず真空中に反応性ガスを投入し高周波電源等による電圧を利用してグロー放電によるプラズマを発生させます。その後、プラズマ中の陽イオンを基板側に発生しているVDCによって引き付け、エッチングをしたい物資へ向かって加速させ真っ直ぐに衝突させることで削っていきます。
この方法は異方性(図2参照)であるため、横方向と縦方向のエッチング速度が異なり、微細な加工が可能となります。
その一方で、イオンの衝突から生じる物理的反応のみを利用するため、エッチング速度が遅くなります。
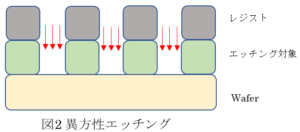
反応性イオンエッチングとは化学的作用と物理的作用を併せ持った方法です。
これは真空中に入れた反応性のガスをプラズマにして加速したイオンをぶつけることで削って行くと同時に、プラズマの励起で生成されるラジカルを利用する化学エッチングで酸化膜を除去します。この方法はスパッタエッチングよりエッチング速度が速く、さらに微細な加工が可能です。
ドライエッチングは微細な半導体回路の歩留まりを向上させるために近年では広く使用されています。
しかし、ウェットエッチングも一気に大量の枚数を処理でき、ダメージフリーでプロセス後もクリーンであるなどから今でも一部の工程で使われています。
目的に合わせて工程を選ぶことが重要です。

